導(dǎo)讀
封裝基板用于承載芯片,連接芯片與PCB 母板,是封裝環(huán)節(jié)價(jià)值量最大的材料。芯片制程不斷演進(jìn)及先進(jìn)封裝技術(shù)的發(fā)展,是封裝基板產(chǎn)品迭代的核心推動(dòng)力。封裝基板行業(yè)高資金投入、嚴(yán)苛技術(shù)要求及較高的客戶(hù)壁壘,一定程度上制約了行業(yè)新玩家的進(jìn)入。全球封裝基板市場(chǎng)主要被中國(guó)臺(tái)灣、日本、韓國(guó)等龍頭企業(yè)把控。而內(nèi)資封裝基板廠商經(jīng)過(guò)近十年的積淀與發(fā)展,正迎來(lái)國(guó)產(chǎn)替代最佳機(jī)遇。
01
封裝基板是什么?
封裝基板(Substrate)是用于建立IC與PCB之間的訊號(hào)鏈接,起著“承上啟下”的作用。封裝基板被應(yīng)用于封裝環(huán)節(jié)中。
封裝基板的作用:
承載IC芯片;
保護(hù)、固定、支撐IC芯片,提供散熱通道;
內(nèi)部有線路,是芯片與PCB之間的橋梁;可埋入無(wú)源、有源器件以實(shí)現(xiàn)一定系統(tǒng)功能。
圖1 封裝基板在芯片中的作用
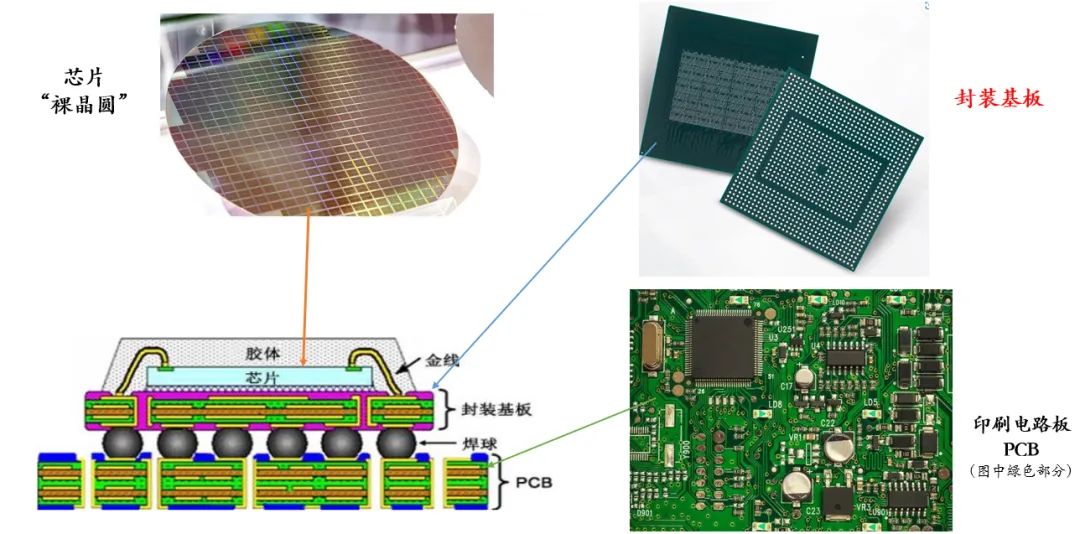
資料來(lái)源:融匯科技團(tuán)隊(duì)整理
封裝基板技術(shù)按照IC與載板的連接方式或載板與PCB的連接方式分類(lèi)。IC與載板的連接方式分為覆晶(Flip Chip FC)及打線(Wire Bounded WB)。載板與PCB的連接方式可分為BGA(Ball Grid Array ,球閘陣列封裝)和CSP(Chip Scale Package, 晶片尺寸封裝)。因此封裝基板可分為四大類(lèi):WB-BGA、WB-CSP、FC-BGA和FC-CSP。
與傳統(tǒng)的引線封裝相比,F(xiàn)C(Flip Chip,倒裝)將裸芯片正面翻覆,以錫球凸塊直接連接載板,提高了載板信號(hào)密度,提升芯片性能,凸點(diǎn)對(duì)位校正方便,提高良率,是更為先進(jìn)的連接方式。
載板與PCB的連接方式有兩種:CSP和BGA。CSP適用移動(dòng)端芯片,BGA適用PC/服務(wù)器級(jí)高性能處理器。BGA(Ball Grid Array,球柵陣列封裝)是在晶片底部以陣列的方式布置許多錫球,以錫球陣列替代傳統(tǒng)金屬導(dǎo)線架作為接腳;
CSP(Chip Scale Package,芯片級(jí)封裝)可以讓芯片面積與封裝面積之比超過(guò)1:1.14,已經(jīng)相當(dāng)接近1:1的理想情況,面積約為普通BGA的1/3PS。表1 各類(lèi)型封裝基板特點(diǎn)

圖2 各類(lèi)型封裝基板應(yīng)用
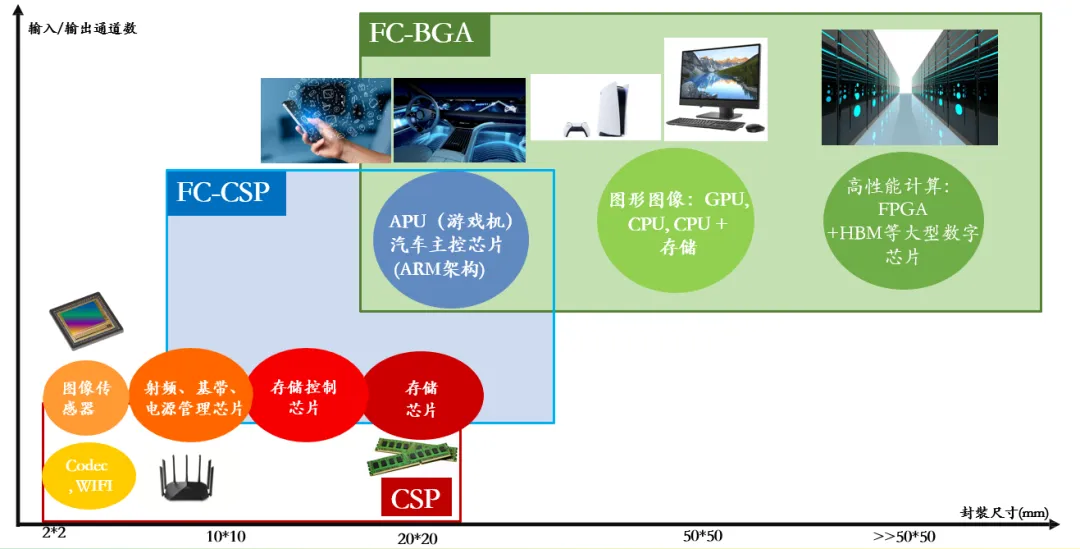
資料來(lái)源:融匯科技團(tuán)隊(duì)整理
02
封裝基板制作工藝
封裝基板的主要功能包括為芯片提供保護(hù)、固定支撐及散熱等。封裝基板在結(jié)構(gòu)及功能上與PCB類(lèi)似,由HDI板發(fā)展而來(lái),但是封裝基板的技術(shù)門(mén)檻要遠(yuǎn)高于HDI和普通PCB,其具有高密度、高精度、高腳數(shù)、高性能、小型化及薄型化等特點(diǎn),在線寬/線距參數(shù)等多種技術(shù)參數(shù)上都要求更高。
表2 封裝基板參數(shù)要求更高
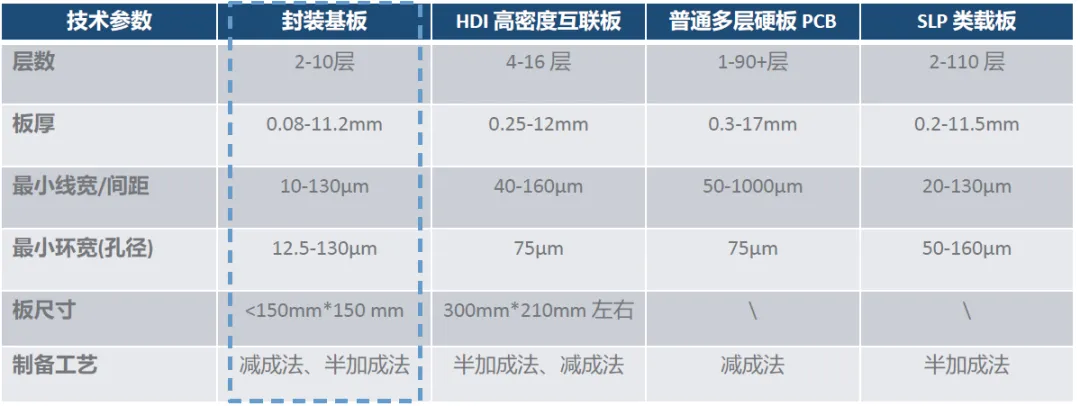
資料來(lái)源:融匯科技團(tuán)隊(duì)整理
從封裝基板產(chǎn)業(yè)鏈看,上游主要為基板、銅箔等結(jié)構(gòu)材料及干膜、金鹽等化學(xué)品/耗材,中游為芯片封裝,下游為移動(dòng)終端、個(gè)人電腦、存儲(chǔ)等各類(lèi)具體芯片應(yīng)用。
制造封裝基板所需的結(jié)構(gòu)材料包括樹(shù)脂基板(BT、ABF)、銅箔、絕緣材料等,其他化學(xué)品/耗材原材料還包括干膜、光阻劑、刻蝕劑、金鹽、鈷針等。樹(shù)脂基板是成本最重的結(jié)構(gòu)性材料。樹(shù)脂基板、銅箔、銅球、絕緣材、金鹽5項(xiàng)原材料在封裝基板原材料成本中占比超過(guò)70%。
圖3 封裝基板制造原材料占比

資料來(lái)源:融匯科技團(tuán)隊(duì)整理
ABF材料和BT材料是半導(dǎo)體封裝基板材料中的兩種硬質(zhì)材料。ABF材料適用于制造線路較細(xì)、高腳數(shù)高傳輸?shù)腎C,如CPU、GPU和晶片組等大型高端芯片。相比之下,BT材料具備耐熱性、抗?jié)裥浴⒌徒殡姵?shù)、低散失因素等多種優(yōu)良特性,常用于穩(wěn)定尺寸,防止熱脹冷縮改善設(shè)備良率。BT載板主要應(yīng)用于存儲(chǔ)芯片、MEMS芯片、RF芯片,應(yīng)用終端主要為智能手機(jī)等各類(lèi)移動(dòng)設(shè)備。
表3 封裝基板主材特點(diǎn)介紹

資料來(lái)源:融匯科技團(tuán)隊(duì)整理
高端基板不僅內(nèi)層路線更為復(fù)雜,需要表面粗化和絕緣貼膜,還需采用超細(xì)線路工藝適配對(duì)線寬/線距的更高需求(<20um)。當(dāng)前國(guó)內(nèi)基板制造工藝偏中低端,主要包括CSP、PBGA等,僅小部分廠商具備高端基板FC-CSP的量產(chǎn)能力。
FC-BGA因內(nèi)層線路步驟增加,導(dǎo)致加工難度高于FC-CSP產(chǎn)品。由于FC-BGA產(chǎn)品層數(shù)通常為高堆疊的8-14層,而FC-CSP為2-4層板,因此FC-BGA內(nèi)建層需要多道積層工序處理,包括在雙面核心板上進(jìn)行ABF壓膜,對(duì)特定孔位進(jìn)行鐳射鉆孔、曝光顯影,再進(jìn)行電鍍及蝕刻工序。內(nèi)建層的層數(shù)越高、工序處理次數(shù)越多,良率也會(huì)相應(yīng)受到影響。此外,F(xiàn)C-BGA通常以顆狀形式出貨,需要面臨基板面積固定、單顆大小受到客戶(hù)指定,材料裁切率受到影響。
圖4 封裝基板制作流程工藝
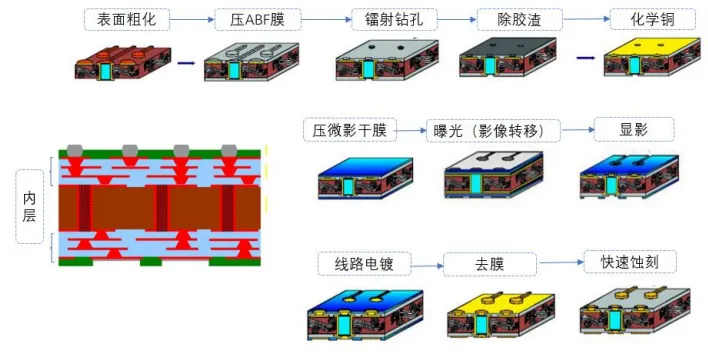
資料來(lái)源:開(kāi)源證券、融匯科技團(tuán)隊(duì)整理
封裝基板目前主流的制作工藝為改良型半加成法。首先在附有超薄底銅的基板上貼合干膜使用正片進(jìn)行圖形轉(zhuǎn)移,再通過(guò)圖形電鍍加成形成線路,最后去除干膜和底銅完成高精密布線。技術(shù)關(guān)鍵控制點(diǎn)在于底銅均勻性、圖形解析度、電鍍均勻性、去膜和褪銅。
表4 封裝基板制作工藝介紹

資料來(lái)源:融匯科技團(tuán)隊(duì)整理
03
封裝基板市場(chǎng)
封裝基板引領(lǐng)PCB行業(yè)產(chǎn)值增長(zhǎng)。Prismark數(shù)據(jù)顯示,全球2020年P(guān)CB產(chǎn)值為652.2億美元,其中封裝基板產(chǎn)值為101.9億美元,同比增長(zhǎng)25.2%,增長(zhǎng)幅度排名第一。展望未來(lái),Prismark預(yù)測(cè)PCB行業(yè)2020-2025年CAGR為5.8%,到2025年全球PCB行業(yè)產(chǎn)值將達(dá)到863.3億美元,其中封裝基板產(chǎn)值為161.9億美元,占比18.75%,20年到25年增長(zhǎng)率為9.7%,引領(lǐng)行業(yè)增長(zhǎng)。
由于中國(guó)封裝基板市場(chǎng)規(guī)模沒(méi)有可靠的公開(kāi)數(shù)據(jù),經(jīng)估算中國(guó)封裝基板市場(chǎng)約為200-300億元。2020年,A股上市公司深南電路和興森科技的封裝基板業(yè)務(wù)營(yíng)收之和為18.8億元,預(yù)計(jì)內(nèi)資公司封裝基板總營(yíng)收20億元左右,占國(guó)內(nèi)市場(chǎng)總規(guī)模不足10%。相比于產(chǎn)值全球遙遙領(lǐng)先的 PCB 產(chǎn)業(yè),內(nèi)資封裝基板行業(yè)具有極大的國(guó)產(chǎn)化空間。
表5 封裝基板市場(chǎng)規(guī)模預(yù)測(cè)

資料來(lái)源:Prismark、融匯科技團(tuán)隊(duì)整理
下游終端應(yīng)用與封裝工藝交替驅(qū)動(dòng)封裝基板市場(chǎng)發(fā)展。2005-2010年,PC 及服務(wù)器芯片快速增長(zhǎng),F(xiàn)CBGA 載板成為封裝基板市場(chǎng)主要增長(zhǎng)驅(qū)動(dòng);2010-2015年,智能手機(jī)興起,移動(dòng)端芯片需求高漲,雖然基板整體出貨量上升,但FCCSP/ETS 載板因面積相對(duì)較小且無(wú)需基材,單位價(jià)值量降低。疊加全球半導(dǎo)體銷(xiāo)售額以及晶圓制造產(chǎn)能增速放緩、PC出貨量下降影響,2011年后市場(chǎng)規(guī)模開(kāi)始下滑;2015年-2020年,得益于HPC、AI計(jì)算、數(shù)據(jù)中心等大數(shù)字芯片對(duì)基板面積、層數(shù)的需求提升,全球封裝基板市場(chǎng)觸底反彈,F(xiàn)CBGA 封裝基板增長(zhǎng)加速;2020年-2026年,F(xiàn)CBGA載板與新興的Chiplet、AiP/SiP等模組載板成為主要驅(qū)動(dòng)因素。
圖5 封裝基板市場(chǎng)走勢(shì)

資料來(lái)源:Prismark、融匯科技團(tuán)隊(duì)整理
04
封裝基板產(chǎn)業(yè)競(jìng)爭(zhēng)格局
全球封裝基板市場(chǎng)集中,CR10>80%,中國(guó)臺(tái)灣、日本、韓國(guó)是主要玩家,內(nèi)資廠商占比僅 5%。國(guó)內(nèi)現(xiàn)有產(chǎn)能絕大部分為中低端載板,高端載板嚴(yán)重空白。
封裝基板技術(shù)最早起源于日本,包括揖斐電(Ibiden)、新光電氣(Shinko)、京瓷(Kyocera)等領(lǐng)先廠商。封裝基板行業(yè)進(jìn)入壁壘高,面臨資金、技術(shù)、客戶(hù)認(rèn)證三大壁壘,市場(chǎng)高度集中,且前期國(guó)內(nèi)配套產(chǎn)業(yè)鏈發(fā)展不盡人意,導(dǎo)致中國(guó)大陸的封裝基板產(chǎn)業(yè)起步較晚,正處于發(fā)力追趕階段。
隨著半導(dǎo)體產(chǎn)業(yè)向韓國(guó)和中國(guó)臺(tái)灣轉(zhuǎn)移,帶動(dòng)韓國(guó)和中國(guó)臺(tái)灣地區(qū)優(yōu)質(zhì) IC 載板企業(yè)的發(fā)展,如欣興電子、景碩科技、南亞電路、三星電機(jī)等。日本企業(yè)由于受到韓國(guó)、中國(guó)臺(tái)灣廠商進(jìn)入的沖擊,退出中低端市場(chǎng),主導(dǎo) FC-BGA、FC-CSP 等高端封裝產(chǎn)品。
同理,隨著半導(dǎo)體產(chǎn)業(yè)向大陸轉(zhuǎn)移,產(chǎn)業(yè)配套需求也會(huì)帶動(dòng)內(nèi)地優(yōu)質(zhì)封裝基板企業(yè)發(fā)展。根據(jù)集微咨詢(xún)數(shù)據(jù)統(tǒng)計(jì),2020年中國(guó)大陸封裝基板內(nèi)資企業(yè)產(chǎn)值約為5.4億美元,全球占比為5.3%。對(duì)比下游封測(cè)廠商格局,中國(guó)大陸企業(yè)在全球已占據(jù)重要份額,市占超過(guò)20%。中國(guó)大陸企業(yè)當(dāng)前仍處于追趕階段,企業(yè)主要以深南電路、興森科技和珠海越亞等傳統(tǒng)大廠代表。亦有創(chuàng)業(yè)公司迎頭趕上。
圖6 全球封裝基板競(jìng)爭(zhēng)格局

資料來(lái)源:Prismark、融匯科技團(tuán)隊(duì)整理
05
結(jié)語(yǔ)
下游應(yīng)用方面,受數(shù)據(jù)中心、5G 基站建設(shè)進(jìn)程加速影響,高性能運(yùn)算芯片需求量大漲,對(duì)高端封裝基板需求也水漲船高;異質(zhì)集成技術(shù)增大了單顆芯片的封裝面積與載板用量,該技術(shù)的成熟也將進(jìn)一步增加高端封裝基板需求。內(nèi)資廠商前期作為模組類(lèi)產(chǎn)品的配套供應(yīng)商,具備低端制程的量產(chǎn)經(jīng)驗(yàn),逐步向CSP、FC-CSP 領(lǐng)域進(jìn)軍。內(nèi)資廠商在人工成本、水電配套環(huán)節(jié)具備優(yōu)勢(shì),盈利有望超越海外廠商。在高階FC-BGA 領(lǐng)域,內(nèi)資廠商在國(guó)內(nèi)半導(dǎo)體產(chǎn)業(yè)基金的扶持及友好的融資環(huán)境下,已進(jìn)入產(chǎn)能布局階段,未來(lái)有望聯(lián)手國(guó)內(nèi)CPU、GPU廠商,切入高階FC-BGA領(lǐng)域。
免責(zé)聲明:凡注明來(lái)源本網(wǎng)的所有作品,均為本網(wǎng)合法擁有版權(quán)或有權(quán)使用的作品,歡迎轉(zhuǎn)載,注明出處。非本網(wǎng)作品均來(lái)自互聯(lián)網(wǎng),轉(zhuǎn)載目的在于傳遞更多信息,并不代表本網(wǎng)贊同其觀點(diǎn)和對(duì)其真實(shí)性負(fù)責(zé)。

